磁控溅射工艺参数对PZT薄膜电性能的影响毕业论文
2020-02-19 16:06:43
摘 要
近年来,有关铁电薄膜材料的研究已经成为国际上的热点,有着钙钛矿结构的PZT铁电薄膜具有优异的铁电性能,因而被广泛用于制作铁电随机存储器(FRAM)。高质量的 PZT 铁电薄膜是提升铁电存储器性能的关键, 而磁控溅射法在薄膜沉积方面具有效率高、自动化、批量化、制备薄膜重复性好、质量高的优势。本文以 Pt/Ti/SiO2/Si 为衬底,使用磁控溅射法制备PZT铁电薄膜,用马弗炉将薄膜样品在设定温度下退火,通过结构表征(XRD)、形貌表征(FE-SEM、金相显微镜)、铁电性能测试(电滞回线、漏电流)来分析样品。实验采用不同的溅射工艺制备PZT薄膜,以便研究溅射工艺参数对PZT薄膜结构和性能的影响,进而确定最佳的溅射工艺。采用正交试验方法设计实验,研究结果表明:最佳的溅射工艺参数为衬底温度100 ℃、功率100 W、气压0.6 Pa、溅射时间3000 s、氧气流量4 sccm。同时研究了薄膜的退火温度(室温、450 ℃、550 ℃、650 ℃分别退火30 min)对PZT薄膜晶化的影响。研究结果表明对于一定厚度的PZT薄膜,650 ℃是最佳的退火温度,可以形成单一的PZT物相。而对于较厚的薄膜,二次退火的方式有助于其结晶形成PZT物相。实验还研究了氧气流量对PZT薄膜性能的影响。
关键词:磁控溅射法;PZT薄膜;XRD;铁电性能
Abstract
In recent years, the research on ferroelectric thin film materials has become an international hotspot. PZT ferroelectric thin film with perovskite structure has excellent ferroelectric properties, so it is widely used to make Ferroelectric Random Access Memory (FRAM). High quality PZT ferroelectric thin film is the key to improve the performance of FRAM. Magnetron sputtering has the advantages of high efficiency, automation, mass production in thin film deposition with good repeatability and high quality. In this paper, Pt/Ti/SiO2/Si was used as the substrate to prepare PZT ferroelectric thin films by magnetron sputtering method. The film samples were annealed at a set temperature in a muffer furnace. The samples were analyzed through structural characterization (XRD), morphological characterization (FE-SEM, metallographic microscope) and ferroelectric performance test (hysteresis loop, leakage current). Different sputtering processes were used to prepare PZT films in order to study the influence of sputtering process parameters on the structure and properties of PZT films, and then we can determine the best sputtering process. Because the comprehensive experiments need to experiment for too many times, the orthogonal experiment method is adopted to design the experiment, and the experiment is arranged according to the orthogonal table. The research results show that the optimal sputtering process parameters. We studied how the annealing temperature of the film make effects on PZT thin film crystallization. The results show that for a certain thickness of PZT thin film, 650 ℃ is the best annealing temperature, PZT thin film can form a single PZT phase in 650 ℃. For thicker films, secondary annealing is helpful for crystallization to form PZT phase. The effect of oxygen flow on the properties of PZT films was also studied.
Key Words: magnetron sputtering;PZT thin film;XRD;ferroelectric property
目 录
摘要 I
Abstract II
第1章 绪论 1
1.1 引言 1
1.2 PZT的性质 1
1.2.1 PZT晶体结构 1
1.2.2 PZT的铁电效应 2
1.2.3 PZT的相图 2
1.3 PZT薄膜的制备方法 3
1.3.1 溶胶-凝胶法(Sol-Gel) 3
1.3.2 溅射法 4
1.4 PZT薄膜的应用背景 6
1.5 论文的研究意义与内容 7
第2章 实验及表征方法 8
2.1 实验方案设计 8
2.1.1 正交试验法设计实验 8
2.1.2 磁控溅射法制备PZT薄膜 9
2.2 PZT薄膜的结构与性能表征方法 11
2.2.1 物相表征 12
2.2.2 形貌表征 12
2.2.3 铁电性能表征 13
2.2.4 介电性能表征 13
第3章 磁控溅射法制备PZT铁电薄膜的研究 14
3.1 PZT薄膜溅射工艺研究 14
3.2 PZT薄膜退火工艺研究 15
3.3 氧气流量对PZT铁电薄膜性能的影响 19
第4章 结论与展望 22
4.1结论 22
4.2 展望 22
参考文献 23
致谢 25
第1章 绪论
1.1 引言
近年来,铁电薄膜材料已经成为新型材料研究中的热点,而PZT(锆钛酸铅)薄膜是目前最重要的铁电薄膜材料之一。PZT薄膜作为铁电存储器的核心材料,具有优良的压电、铁电、介电性热释电性能,因而也被广泛运用于MEMS(微机电系统)领域[1]的其他器件,比如:数字开关[2]、振动能量釆集器[3-6]与燃料电池[7-9]、压电式微机电超声传感器(pMUT)[10-13]、热电红外探测器等[14]。此外,PZT薄膜在光电子领域也有应用。PZT 薄膜器件具有响应快,探测信号快,结构紧凑,机械强度好[15],可提高波长范围等特点,为器件的集成化和微型化创造条件[16]。
PZT薄膜的性能与其晶体结构有紧密的关系,优越的结晶性能是得到高性能PZT薄膜的保证。PZT薄膜制备工艺中存在众多影响因素,制得的PZT薄膜存在的各种缺陷也会影响PZT薄膜的性能,所以得到高性能的PZT薄膜存在一定难度。因此,掌握薄膜的结晶特性,分析影响薄膜生长的因素,优选出合理的工艺参数,制备高质量的PZT薄膜具有巨大的实际意义,是科研工作者努力的方向和研究热点。 目前,PZT 薄膜材料的制备和应用研究已成为铁电学研究的热点之一[17, 18]。
1.2 PZT的性质
1.2.1 PZT晶体结构
PbZrO3和PbTiO3都具有典型的钙钛矿ABX3的结构,PZT是PbZr1-xO3和PbTixO3的连续固溶体(0≤x≤1)。因而PZT是钙钛矿相的变体,PZT中Zr原子和Ti原子占据钙钛矿相的B位,且两种原子的比例可以连续变化。PZT的晶胞结构如左图所示,Pb2 半径较大,占据晶胞的顶点位置,O2-分布在晶胞的面心位置,而Zr4 /Ti4 半径较小,占据晶胞的体心位置。如右图所示,O2-构成氧八面体,Zr4 /Ti4 填入氧八面体空隙的位置,氧八面体共顶连接形成PZT的三维结构。
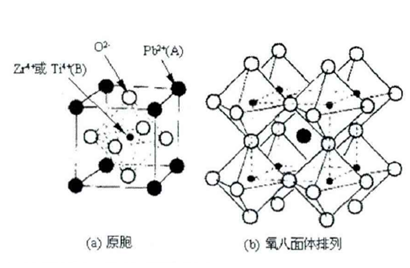
图1.1 (a)PZT原胞结构图, (b)PZT氧八面体共顶连接结构图
1.2.2 PZT的铁电效应
PZT作为典型的铁电材料,其良好的铁电性能晶体结构密切相关,既得益于B位离子(Zr4 、Ti4 )较小的离子半径、较大的电价,也得益于钙钛矿结构氧八面体共顶连接的特性。PZT晶体并不是理想的钙钛矿结构,A位阳离子和B位阳离子的半径rA、rB与氧离子半径rO之间不满足理想钙钛矿结构关系式:rA ro=(rB ro)。PZT中Zr4 /Ti4 的半径(rB)较小,结构无法稳定,容易产生畸变,从而产生铁电性能。铁电晶体是指具有自发极化且极化强度可以随外加电场反向而反向的晶体,铁电性能出现与晶体的自发极化有关。自发极化来自于晶胞中某些离子发生位移,造成正负电荷中心不重合,从而产生电偶极矩。一般晶体中离子只能作弹性位移,离子发生位移偏移平衡位置后在恢复力作用下很快又回到其平衡位置,无法在新的位置固定下来,也就无法产生自发极化。PZT中Zr4 和Ti4 发生移动偏离氧八面体体心的位置后,受到的恢复力比较小。且Zr4 和Ti4 的电价比较高,与O2-作用非常强烈。当Zr4 /Ti4 发生位移向某一O2-靠近时,O2-的电子云变形,O2-向Zr4 /Ti4 靠拢并发生强烈的电子位移极化,电子位移极化所产生的电场又会进一步促使Zr4 /Ti4 位移。Zr4 /Ti4 直到恢复力与内电场力(极化力)平衡时才会在新位置上固定下来,产生电偶极矩。此外,PZT能够具有自发极化,除了较小的恢复力、B位离子位移后具有的强大内电场以外,氧八面体的共顶连接方式(B—O—B,B=Zr/Ti)也是非常重要的条件。以金红石结构为例,虽然存在氧八面体,八面体中心也存在高价阳离子Ti4 ,但是氧八面体不是共顶连接,不构成离子直线,极化无法扩展从而形成电畴,因此不能产生自发极化。
1.2.3 PZT的相图
PZT是PbZrO3和PbTiO3两种化合物组成的固溶体系,因为Zr4 与Ti4 的离子尺寸接近,所以这两种物质可以无限互溶,形成连续型固溶体PZT,如图1.2是P(Zr1-x,Tix)O3的相图。Tc线是居里温度线,温度高于Tc时,PZT始终表现为顺电相,不具有铁电性;温度低于Tc时,存在多个相区域。以室温来分析,当x<0.05时,PZT为正交反铁电相A0。当0.05<x<0.48时,PZT为铁电三方相FR。在这个相区域中存在一条相界,将低温铁电三方相FR(LT)和高温铁电三方相FR(HT)分隔开来。低温铁电三方相FR(LT)和高温铁电三方相FR(HT)的区别在于氧八面体的取向不同。我们可以在图中看到,这个相变的温度要远低于居里温度Tc。在这条相界附近,晶体容易产生自发极化,且热释电常数较大。当x>0.48时,PZT为铁电四方相FT。x=0.48时,存在一条铁电三方相FR与铁电四方相FT的分界线,这条线就是准同型相界(MPB),此处对应的居里温度Tc约为380℃。在这条相界附近,PZT的介电、压电、铁电性能都达到最优值。对PZT的性能研究往往集中于准同型相界附近,因而我们制备的PZT薄膜也采用x=0.48的组分。
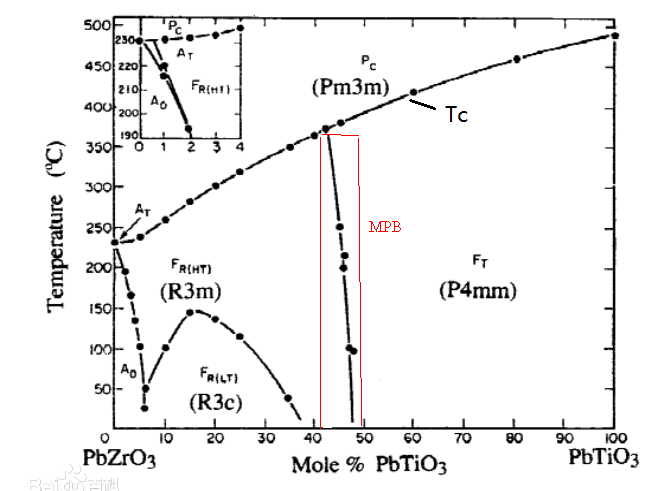
图1.2 PZT的相图
1.3 PZT薄膜的制备方法
制备PZT薄膜的方法可以分为物理法和化学法:
物理法:脉冲激光沉积法(PLD)、溅射法、分子束外延法(MBE)等;
化学法:溶胶-凝胶法(Sol-Gel)、化学气相沉积法(CVD、MOCVD)、金属有机物分解法(MOD)等。
现选取最具代表性的溶胶-凝胶法和溅射法做简单介绍。
1.3.1 溶胶-凝胶法(Sol-Gel)
溶胶-凝胶法在制备薄膜时是一种常用的方法。溶胶-凝胶法的化学过程首先是将薄膜的组分(通常是高反应活性的有机金属化合物)分散在溶剂中,然后经过水解反应生成活性单体,活性单体再进行聚合反应,从而得到均一稳定的溶胶,接着生成具有一定空间结构的凝胶,经过干燥和热处理,得到所需要的薄膜。目前,溶胶-凝胶法制备PZT薄膜的工艺已经比较成熟,常用制备方案有两种:第一种方案基于水,以醋酸为催化剂;第二种方案基于乙二醇等有机溶剂。该方法的工艺流程如图1.3所示。

图1.3 溶胶-凝胶法(Sol-Gel)工艺流程
溶胶-凝胶法制备薄膜最大的优点是合成温度低。溶胶-凝胶法工艺流程简单、成本相对较低,可以实现大规模生产。通过对原料的精确控制,可以对薄膜化学计量比和掺杂进行精准把控。但是溶胶-凝胶法制备薄膜存在致密度较差、表面平整度不理想、薄膜易开裂等缺点。
1.3.2 溅射法
溅射法原理是使用高能离子轰击靶材,将溅出材料沉积在基片表面形成薄膜。溅射法是一种物理气相沉积方法制备薄膜的手段。溅射法主要分为磁控溅射和离子束溅射两种。离子束溅射的原理是,离子源产生惰性气体或反应气体离子束,离子束直接轰击靶材表面,将靶的原子溅射出,沉积到衬底。兴起于二十世纪末的磁控溅射法原理稍微不同,溅射时,电子被磁场约束在一个环状空间,形成高密度等离子体区域。在区域内,惰性气体电离,加速的气体离子轰击靶材表面,溅出靶材原子,沉积到基片的表面形成薄膜。溅射法也存在一定的缺点:由于溅射过程中,溅射各组分的挥发性差别可能较大,最终得到薄膜的成分可能会与靶材的成分不同,溅射的工艺条件决定了差异的大小。下面简要介绍离子束溅射法与磁控溅射法:
(1)离子束溅射法
离子束溅射时,离子源产生高度集中的离子束,离子束以一定角度轰击靶材表面,使得材料溅射至衬底。与磁控溅射相比,离子束溅射具有自己的优点。离子束溅射过程对基片没有热辐射,对基片材料的限制较少,而磁控溅射法制备薄膜温度较高,基片材料要承受高能量电子、离子的轰击。此外,离子束溅射法相对于磁控溅射法而言,沉积速率比较慢,因此离子束溅射比较容易控制,可以沉积出均匀的超薄薄膜。
(2)磁控溅射法
磁控溅射法加入了磁场,将电子约束在靠近靶面的一个等离子区域内,在这个区域内,电子不断与Ar原子发生碰撞,不断电离出Ar 来轰击靶材表面。等离子区域内的电子在不断与Ar原子的碰撞中能量逐渐降低,逐渐摆脱磁场的约束,最后落在基片上。磁控溅射法解决了一般溅射镀膜方法存在的电子与Ar原子碰撞的几率低、电子运动路径较短等问题,增大了溅射效率,同也避免了基片升温过快。磁控溅射法与微电子工艺的兼容性较好,制备薄膜的结晶质量高、结晶温度低,容易获得均一致密的薄膜。磁控溅射法的缺点就是制备薄膜的速度很慢,因而也难以进行大规模生产。
下面介绍几种主要的磁控溅射方式:
- 直流(DC)磁控溅射
直流磁控溅射使用直流电源,原理是直流辉光放电。直流溅射镀膜时,靶材为阴极,电荷会在靶材表面不断累积。如果溅射靶材是绝缘体,正电荷会大量聚集在靶材表面,靶材的阴极负偏压被抵消减弱,同时电场强度也由于靶材表面的电位增大而减小,入射的惰性气体正离子能量不足无法使靶材原子产生溅射。所以直流磁控溅射不能用于绝缘材料,只能用于金属靶材和导体靶材的溅射。与射频磁控溅射相比,直流磁控溅射法不需要配备昂贵的射频电源装置,也不需要复杂的外部网络匹配装置,在工业上已经被大量使用。
- 射频(RF)磁控溅射
射频磁控溅射利用的是射频放电原理,当在两个电极上加载的高频交流电压增高到射频功率时,产生稳定的射频辉光放电。射频电压可以穿过任何种类的阻抗,靶材不再要求是导电体,因此射频磁控溅射解决了直流磁控溅射中离子引起的靶带电问题,适合溅射绝缘体。但是射频磁控溅射,装置比较复杂,大功率的射频电源价格也比较高,因此射频磁控溅射不适于工业生产的应用。
- 反应磁控溅射
反应磁控溅射法是在磁控溅射过程中,人为控制地引入某些活性反应气体,与溅射出来的靶材物质进行反应沉积在基片上,由此来获得不同于靶材物质的化合物薄膜或合金薄膜。例如,在O2气氛下可以获得氧化物,在N2气氛中溅射得到氮化物等。反应磁控溅射法有如下几个优点:元素靶材和反应气体纯度较高,可制备高纯度薄膜;反应磁控溅射制备的薄膜化学组分可控,可以通过改变沉积工艺参数,调节薄膜组成;反应磁控溅射基片温度较低,也不用加热基片,对基片的限制较少;反应磁控溅射可以制备大面积均匀薄膜,能够实现工业化大规模生产,从目前工业生产对化合物薄膜的需求来看,反应磁控溅射法具有相当明显的优势。当然,反应磁控溅射也存在一定的问题,比如引起靶中毒的引弧(弧光放电)现象,该现象会导致膜缺陷,严重影响薄膜的质量。
- 脉冲磁控溅射
脉冲磁控溅射法采用矩形波电压的脉冲电源进行磁控溅射沉积,以此代替传统直流电源。脉冲磁控溅射可以克服反应磁控溅射中的电弧问题,进而消除由此产生的薄膜缺陷。脉冲磁控溅射的优点还有沉积速率高,沉积温度比较低。
1.4 PZT薄膜的应用背景
随着PZT薄膜制备工艺的发展,PZT薄膜器件研究取得了长足的进展,如今,PZT薄膜已经被广泛应用在微电子、微机械、光学、微机电系统(MEMS)领域。
- 铁电随机存储器FRAM(Ferroelectric Random Access Memory,FRAM)
铁电随机存储器是一种断电之后不会丢失内容的非易失性存储器。铁电随机存储器利用了铁电薄膜存在剩余极化的性质,即外加电场。电压撤去以后,铁电薄膜仍然存在剩余极化强度[19, 20]。因此即使在外电场、外电压撤去以后,铁电存储单元仍可以保持原有的极化信息,不同于动态随机存储器(DRAM)需要电源才能保持原有信息。铁电薄膜最主要的应用之一就是铁电随机存储器。铁电随机存储器作为上世纪80年发展起来的一种新型存储器,具有优秀的应用前景,吸引了世界上众多大型微电子公司投入大量精力对其进行研究。
- 动态随机存储器DRAM(Dynamic Random Access Memory,DRAM)
动态随机存储器是一种有代表性的PZT薄膜应用器件,与铁电随机存储器类似,也是一种被广泛应用的存储器,其销售量约占全球集成电路市场的1/10,其销售量和销售额在集成电路领域都首屈一指。DRAM的存储单元核心是一个晶体管和一个存储电容,结构非常简单。PZT薄膜的大介电常数、高耐击穿场强特性,十分符合动态随机存储器对材料的要求。
- 微机电系统(Microelectromechanical System,MEMS)
微机电系统是指微机械器件与微电子器件相集成的系统。MEMS传感器出现在20世纪70年代,最早开始于美国,主要是利用硅片制作的压力传感器,随着MEMS大规模商业化的应用开始,MEMS传感器的制作工艺不断提升、传感器功能的不断丰富、体积不断缩小,对高性能材料的需求也日益增大[21]。PZT薄膜具有的优良介电、压电、热释电和铁电性质使得其成为MEMS技术中应用非常广泛的薄膜材料。
- 薄膜体声波谐振器(Thin Film Bulk Acoustic Resonator,FBAR)
薄膜体波谐振器(FBAR)是一种利用功能材料的机电耦合效应,通过体声波将电场能量转换为机械能的电-声器件,由于其Q值高、谐振频率高、损耗低和体积小等特点,成为解决现代无线通信系统高度微型化、集成化和低功耗的关键器件和研究热点[22]。PZT薄膜具有很高的机电耦合系数以及很高的介电常数,在改善FBAR带宽、减小FBAR器件尺寸和厚度方面有明显优势。应用PZT薄膜可以制备大带宽、低差损的FBAR器件,这些器件在通信和侦听等民用、军事领域都有着广泛应用。
1.5 论文的研究意义与内容
本次毕业设计课题采用磁控溅射法制备PZT薄膜,通过实验掌握磁控溅射法制备薄膜的方法。
对制备的PZT薄膜进行表征(XRD、FE-SEM等),研究磁控溅射工艺(溅射工艺、退火工艺等)改变对PZT薄膜性能的影响,并分析作用机理,加强利用XRD、FESEM等表征手段的对材料进行分析的能力。优选工艺方案,确定合理的工艺参数,得到满足工业使用需求的、高性能的PZT薄膜。
第2章 实验及表征方法
2.1 实验方案设计
2.1.1 正交试验法设计实验
在科研实验、生产实践的过程中,我们经常需要通过试验来研究问题,但通常研究一个问题时,我们要考虑的影响因素会有多种,而这些影响因素又往往存在多个水平条件。考虑到人力物力的耗费,对每一个影响因素的每一种水平条件全面进行组合、逐一试验进行考察是不切实际的。举例来说,做一个2因素2水平的全面试验,仅仅需要做4次试验,但如果将因素、水平数目各自增加两个达到4因素4水平,再想进行全面试验就需要44=256次试验才能完成。如果再增加因素、水平数目,全面试验所需次数会以指数形式增加。由此可见,如果进行全面试验,试验次数会非常多,实验任务会非常繁重,不仅要花费大量人力、物力,而且时间条件上也不允许,因此正交试验方法具有相当的优越性,利用正交设计的主要工具正交表来安排试验,可以将试验的次数显著减少。此外,通过正交试验的方法,我们可以解答哪一种因素水平搭配最好、哪一个因素对生产指标影响最大、不同因素之间是否存在交互作用等一系列问题。
以上是毕业论文大纲或资料介绍,该课题完整毕业论文、开题报告、任务书、程序设计、图纸设计等资料请添加微信获取,微信号:bysjorg。
相关图片展示:

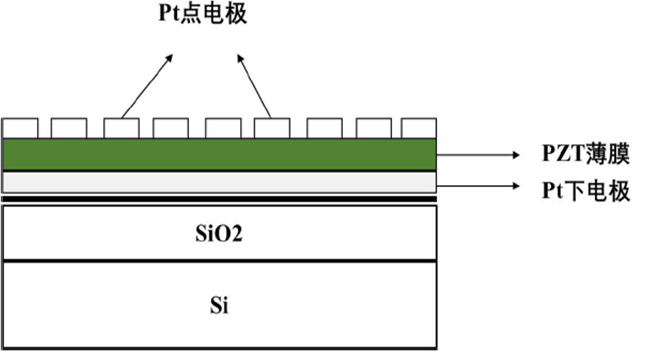

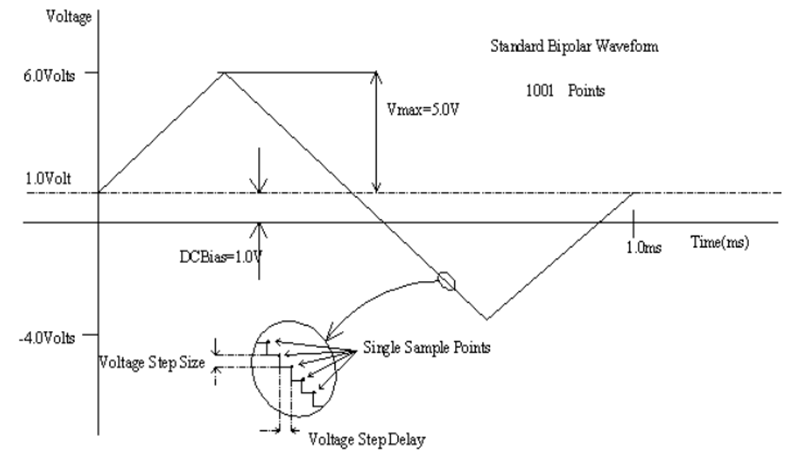

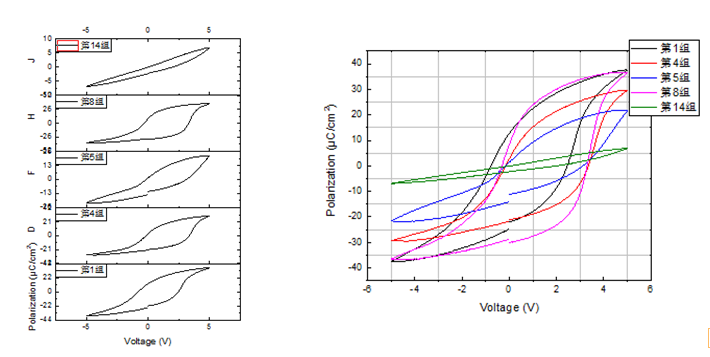
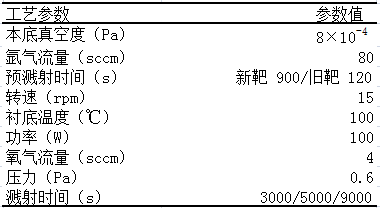
您可能感兴趣的文章
- 激光作用下ZrNiSn合金热电材料组成、结构和性能的演化规律开题报告
- 原位生长于碳纤维表面的钒氧化物柔性电极制备开题报告
- 锂硫电池用TixOy-S/HGs复合材料的制备与性能开题报告
- MnO2纳米片修饰ZnO纳米棒阵列的气敏性能研究开题报告
- 基于三维碳基孔结构和电解质协同优化的微型超级电容器文献综述
- 基于C-MEMS工艺的微型混合锂离子电容器构筑及性能开题报告
- 多孔碳负载钼基纳米材料作为高性能析氢电催化剂文献综述
- Cu掺杂ZnxCd1-xS纳米晶的制备与性能研究开题报告
- 用于光伏的III-V族半导体低成本生长外文翻译资料
- 太阳能电池中的GaSb / InGaAs 量子点阱混合结构有源区外文翻译资料




